多芯粒2.5D/3D集成技術(shù)研究現(xiàn)狀
面向高性能計算機、人工智能、無人系統(tǒng)對電子芯片高性能、高集成度的需求,以 2.5D、3D 集成技術(shù)為....

超短脈沖激光加工技術(shù)在半導體制造中的應(yīng)用
隨著集成電路高集成度、高性能的發(fā)展,對半導體制造技術(shù)提出更高要求。超短脈沖激光加工作為一種精密制造技....

射頻系統(tǒng)先進封裝技術(shù)研究進展
通信、雷達和微波測量等領(lǐng)域電子信息裝備迅速發(fā)展, 對射頻系統(tǒng)提出了微型化、集成化和多樣化等迫切需求。....
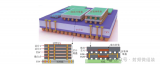
基于疊層組裝和雙腔體結(jié)構(gòu)的高密度集成技術(shù)
產(chǎn)品集成11顆芯片,58個無源元件,采用雙面陶瓷管殼作為載體,進行雙層芯片疊裝和組裝,實現(xiàn)高密度集成....

芯片級封裝的優(yōu)勢和分類
CSP的概念最早于1993年由Fuiitsu公司的Junichi Kasai和Hitachi Cab....
飛秒激光技術(shù)在微流控芯片中的應(yīng)用
和傳統(tǒng)芯片不同,微流控芯片更像是一個微米尺度的“生化反應(yīng)平臺”。詳細來說,微流控芯片是一種將生物、化....

一文詳解多芯片堆疊技術(shù)
多芯片堆疊技術(shù)的出現(xiàn),順應(yīng)了器件朝著小型化、集成化方向發(fā)展的趨勢。該技術(shù)與先進封裝領(lǐng)域中的系統(tǒng)級封裝....

芯片封裝鍵合技術(shù)工藝流程以及優(yōu)缺點介紹
芯片封裝是半導體制造的關(guān)鍵環(huán)節(jié),承擔著為芯片提供物理保護、電氣互連和散熱的功能,這其中的鍵合技術(shù)就是....